

摘要
化學沉鎳金(ENEIG)工藝作為無鉛適應性的一種表面處理已經成為無鉛電子產品表面處理的主流工藝,化學沉鎳金表面處理的鍍層質量、表面清潔程度和鎳腐蝕現象等是影響其可焊性的重要因素。本文結合具體的失效案例,詳細介紹了由上述原因導致PCB焊盤可焊性不良的表現形式、分析方法和思路,可為PCB業界同行在分析可焊性不良問題時提供參考。
1 前言
隨著無鉛工業時代的到來,常見的PCB表面處理方式有:化鎳金(ENIG)、沉銀(Immersion Silver)、沉錫(Immersion Tin)和OSP膜(Organic Solderability Preservative)[1-2]。其中,沉金也叫無電鎳金、沉鎳浸金或化金,是一種在印制線路板(PCB)裸銅表面涂覆可焊性涂層的工藝,其集焊接、接觸導通、打線和散熱等功能于一身,滿足了日益復雜的PCB組裝焊接要求,受到PCBA(printed circuit boardassembly,即PCB組裝)客戶的親睞[3]。
但隨著無鉛焊接峰值溫度的提高,因無鉛焊料的熔點為217℃,使焊接工藝窗口由50 ℃(有鉛焊接)減小到15 ℃(無鉛焊接)。焊料、PCB表面處理和元器件表面處理的多元化,出現了很多兼容性問題,尤其是帶來了更復雜的沉金PCB可焊性問題[4]。本文將重點分享幾例常見沉金PCB可焊性不良的失效案例,總結其失效機理和失效原因,為分析、解決沉金PCB可焊性不良問題提供有力的分析方法和思路。
2 案例及分析方法
2.1 金厚不足導致的可焊性不良
一般而言,化學沉鎳金工藝中的金層厚度要求控制在0.05 ~0.15μm之間,金層偏薄將使其對鎳層的保護作用會有所下降,尤其是導致經過長時間的儲存、貼裝前烘烤或者貼裝過程中的高溫老化后其引起的PCB可焊性不良現象會更加顯著。以下分享一例由金厚偏薄引起的焊接不良的案例,不良外觀如下圖1所示:

由以上圖片可知,不良PCB焊盤上錫不良而且呈現金面發白現象。
使用X-Ray測厚儀對PCB進行金厚測量確認,結果如表1所示:

如表1所示,使用X-ray測厚儀對PCBA未焊接位置金厚進行測試,發現不良PCB焊盤的平均金厚0.033μm,金厚低于工藝控制要求。
通過掃描電子顯微鏡及X射線能譜儀上錫不良的焊盤進行表面形貌觀察(SEM)及元素分析(EDS),確認焊接不良位置的表面情況,結果如下圖2所示:
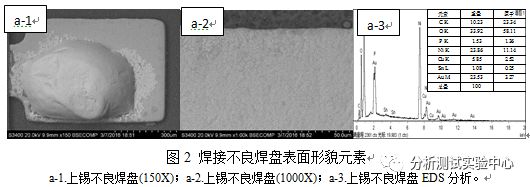
由以上SEM圖片和EDS分析結果得知,上錫不良焊盤未發現明顯污染物,說明該位置可焊性不良非污染導致;而EDS元素分析發現焊盤表面的O(氧)含量偏高,這是由于金厚偏薄,焊接時高溫作用使焊盤中的鎳原子遷移至金層表面,并在焊盤表面生成了氧化鎳。
為改善因現有板金層過薄導致鎳原子在焊盤表面被氧化而造成可焊性不良的問題,對上錫不良的焊盤進行酸洗后浸錫,結果如圖3所示。發現酸洗后原先上錫不良的位置上錫良好。酸洗能夠有效去除板面的氧化層,說明原先金層對鎳層的保護不足,導致在回流焊接過程中鎳原子遷移至金層表面被氧化,生成的含鎳氧化物熔點甚至高達2000℃,在回流焊接過程中阻擋焊接基底與錫料原子之間的相互擴散,從而使焊盤的潤濕性能下降,導致上錫不良。
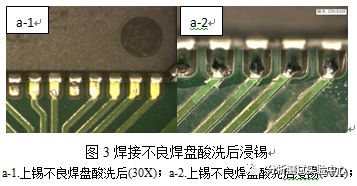
2.2 表面污染導致的可焊性不良
2.2.1 金面雜質離子殘留
在沉金表面處理后,如焊盤表面未清洗干凈,會有氯、溴等鹵素離子或其他酸堿性雜質離子殘留。這些殘留物與空氣中的氧和水汽在長時間的作用下就會使鍍層氧化,從而降低焊盤的可焊性。即使PCB清洗干凈,而由于存放環境不良,長時間存放在潮濕空氣或者含有酸、堿等物質的氣氛中,焊盤表面也會逐漸發生氧化而出現表面異色等現象,形成可焊性不良的失效現象。以下分享一例PCB焊盤表面被氧化物污染導致上錫不良的案例,不良板的外觀如下圖4所示:
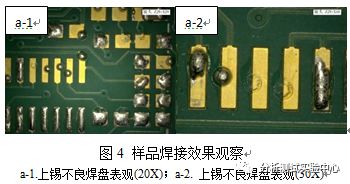
由以上圖片可知,不良PCB焊盤不潤濕,出現“金不溶”現象。
對PCBA未焊接但金面存在異色發紅的位置進行形貌觀察及元素分析,分析確認其可焊性不良的原因,結果如下圖5所示:
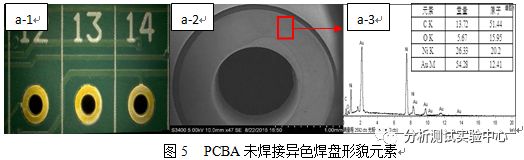
PCBA部分焊盤存在發紅現象,EDS元素分析發紅位置C(碳)含量偏高,未發現其它異常特征元素,疑似存在污染離子。
為驗證其可焊性不良的真正原因,對金面發紅的焊盤進行酸洗前后的可焊性驗證,浸錫結果表明,金面發紅的焊盤均出現可焊性不良現象,而酸洗后原先上錫不良的位置上錫良好。酸洗能夠有效去除板面的氧化層,說明該板不良主要是由于焊盤表面存在一層較薄的氧化物,而經過稀鹽酸清洗能將其去除,從而改善焊盤的潤濕效果。
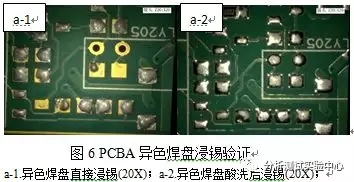
2.2.2 金面異物殘留
表面污染除了氧化物以為,還有其他的污染也會導致PCB出現可焊性不良現象。以下分享一例PCB焊盤阻焊余膠導致上錫不良的案例,不良外觀如下圖7所示:

由以上圖片可知,焊接不良焊盤表面分布著大量的綠色污染物,從焊接效果可知,上錫不良焊盤的失效模式為不潤濕模式,即錫膏不潤濕焊盤,懷疑該焊盤不上錫原因可能是焊盤表面為阻焊余膠。
通過掃描電子顯微鏡及X射線能譜儀對不上錫的焊盤表面及正常鉆位置進行微觀形貌觀察及元素分析,結果如下圖8所示:
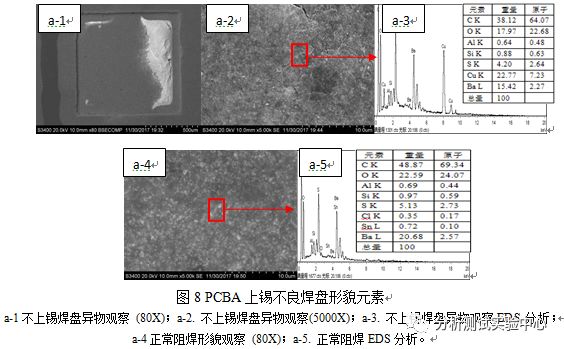
微觀形貌觀察發現,在成份像背散射模式下,焊盤表面污染物與周邊阻焊存在相似性,其二次像形貌與阻焊形貌也存在一致性,EDS元素分析表明,該污染物與阻焊均含有元素Si、S、Ba一致,故進一步推斷污染物為阻焊余膠。
從上述分析看出,造成該板可焊性不良的原因為金面殘留有阻焊余膠。為了進一步驗證導致不良板可焊性不良的根本原因,使用氫氧化鈉溶液,在水浴鍋中80℃恒溫半小時,去除阻焊余膠后,分析焊盤形貌元素,如圖9所示。

由以上形貌元素分析得,褪阻焊后的焊盤表面為銅面,沒有Ni(鎳)和Au(金)元素。
對褪阻焊后的焊盤進行可焊性驗證測試,結果表面不上錫焊盤表面殘留的阻焊褪掉后浸錫可焊性良好,說明該板不上錫主要原因為焊盤表面阻焊余膠導致該焊盤未沉上鎳金,在焊接過程中阻擋了焊料在焊盤表面的擴散從而引起可焊性不良現象。

2.3 鎳腐蝕對可焊性的影響
鎳層作為金層和銅層之間的過渡層,起到阻擋銅和金相互擴散的作用,同時其還是焊接的基底層。鎳層過薄會削弱其阻擋銅金原子之間的擴散作用,同時導致有效焊接的厚度變薄,無法形成良好的焊點。對于化學鍍鎳金工藝來說,其本質是一個置換反應,由于置換反應獲得的金層為疏松多孔結構,且金原子體積大,在浸金反應后期,雖然金層厚度不再增加,但金原子間隙下的鎳層仍然可以繼續被置換。鎳過度置換產生的鎳離子往往積累在金層下面,鎳離子被氧化后就生成黑色氧化物,這也就是所謂的黑盤(鎳腐蝕)。鎳氧化物的浸潤能力很差,因而黑盤對鎳金層的可焊性會產生致命影響。以下分享一例焊接后部分焊盤發黑不良的案例,不良外觀圖片如下圖11所示:

通過掃描電子顯微鏡及X射線能譜儀對上錫不良焊盤進行微觀形貌觀察及元素分析,結果如圖12所示:

通過以上分析發現,發黑焊點表面主要元素為C(碳)、O(氧)、P(磷)、Ni(鎳)、Sn(錫),且鎳層晶格之間呈現“龜裂狀”,疑似有鎳腐蝕現象。一般焊接過程應為:首先Au(金)在高溫下擴散至焊點內部,然后Ni(鎳)和Sn(錫)之間形成IMC層。焊點發黑處未發現Au(金),說明第一步已經完成;但是第二步卻未完成,焊點發黑處均為裸露的Ni(鎳)層晶格形態。而鎳在高溫下急劇氧化使得焊點呈現黑色,因此O(氧)含量偏高。
以上分析發現黑盤位置存在表面鎳腐蝕現象,現對該焊點及未焊接的孔環微切片制作后再觀察其截面鎳層情況,結果如下圖13所示:
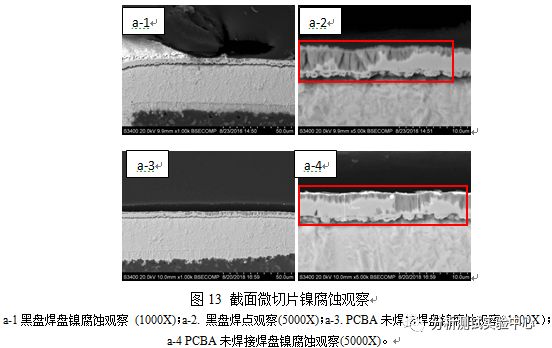
通過黑盤焊點截面觀察發現,鎳層存在嚴重的連續性鎳腐蝕現象;未焊接焊盤的截面鎳腐蝕觀察,同樣發現深度鎳腐蝕現象,金層以下鎳層已完全氧化、鈍化,在掃描電子顯微鏡背散射像(BSE)下呈現黑色形態(連續性鎳腐蝕)。由此說明該板焊接后出現黑盤現象主要是嚴重鎳腐蝕所引起。
2.4 金層、鎳層損傷導致的可焊性不良
金層作為最外層的保護層,起到抗腐蝕防氧化的作用。金層表面有劃傷、孔洞及經過噴砂處理均會造成對鎳層的保護不足;鎳層作為金層和銅層之間的過渡層,起到阻擋銅和金相互擴散的作用,同時其還是焊接的基底層,若鎳層出現孔洞或者疏松等現象均會引起鎳層氧化不上錫現象。
2.4.1 金面孔洞
以下分享一例金面孔洞導致可焊性不良的案例。不良外觀如下圖14所示:
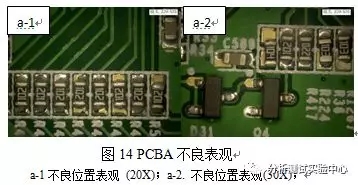
通過掃描電子顯微鏡及X射線能譜儀對上錫不良焊盤進行微觀形貌觀察及元素分析,結果如圖15所示:

從以上分析結果可以看到,焊接不良位置發現較多孔洞。元素分析結果顯示,上錫不良位置含C(碳)、O(氧)、P(磷)、Ni(鎳)、Sn(錫)、Au(金)等元素,P(磷)、Ni(鎳)來自于沉鎳層,Au(金)來自沉金層,Sn(錫)來自焊料殘留;其中Ni(鎳)含量為50%,且線性掃描發現孔洞位置金厚接近零線,說明孔洞位置出現漏鎳現象,存在金層對鎳層保護不足而氧化的風險。
對不良板焊點進行截面微切片制作后觀察,結果如圖16所示:

由上圖可知,不良板焊盤截面微切片發現孔洞寬度在1.46μm~1.71μm之間,深度在0.45μm ~1.29μm之間,且孔洞位置出現焊接不連續的現象。由以上分析結果可知,焊點孔洞位置并非鎳腐蝕,而是本身鎳層存在孔洞且孔洞較大,在沉金的過程中金層無法有效沉積在孔洞內的鎳層表面,導致鎳離子向金層擴散氧化,引起可焊性不良現象。
2.4.2 金面劃傷
以下分享一例金面劃傷導致可焊性不良的案例。不良外觀如下圖17所示:
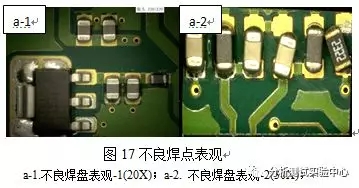
對不上錫位置金面進行形貌觀察及元素分析,結果如圖18所示:

如上圖所示,對上錫不良的板面進行形貌觀察及元素分析,發現上錫不良位置存在密集的劃傷,劃傷位置存在嚴重露鎳狀況,且元素結果顯示C、O含量偏高。
為進一步驗證不良板可焊性問題是由于焊盤劃傷處鍍層保護不足所引起的,現對不良板分別采用異丙醇清洗和稀鹽酸清洗后浸錫,浸錫結果顯示,異丙醇清洗后浸錫可焊性未得到改善,而使用稀鹽酸清洗后浸錫可焊性良好,酸洗能夠有效去除板面的氧化層,說明該板可焊性不良原因是由于金層被劃傷裸露在表面的鎳層被氧化,引起可焊性不良。
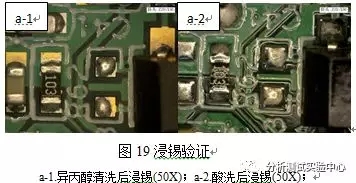
2.4.3 金面噴砂
以下分享一例金面噴砂導致可焊性不良的案例。不良外觀如下圖20所示:
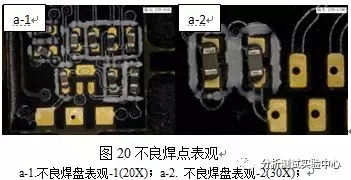
對不上錫位置金面進行形貌觀察及元素分析,結果如圖21所示:
如上圖所示,對PCBA上錫不良位置形貌觀察及元素分析,發現上錫不良位置形貌異常,為噴砂后的金面形貌;沉金金面噴砂會導致金厚變薄,甚至破壞金層對鎳層的保護導致露鎳,露出的鎳暴露在空氣中被氧化,在焊接時會影響焊料與焊接基底鎳層之間形成金屬間化合物IMC層,導致可焊性不良上錫不良。元素分析未發現其它異常特征元素;線性掃描結果顯示線掃描露鎳。
3 分析結論
(1)常見的化學沉鎳金可焊性不良原因主要有以上案例中提到的幾點:鍍層厚度不足、金層表面污染、鎳腐蝕、鍍層損傷等;
(2)在焊接過程中,鍍層最大的作用就是保護焊接面不受氧化、污染,在焊料鋪展時,基底層能夠與錫料快速融合,形成質量可靠的焊點。鎳層作為金層和銅層之間的過渡層,起到阻擋銅和金相互擴散的作用,同時其還是焊接的基底層,所以金層偏薄或者金層出現損傷或者鎳層本身存在質量問題,都將存在對鎳層保護不足引起可焊性不良的風險
深圳市福躍達電子科技有限公司
聯系人:周玉
電話:13828893597
座機:0755-29819639
傳真:0755-29672986
地址:廣東省深圳市龍華大浪街道高峰社區華榮路33號億康商務大廈A棟8058
